- 您的位置:
- 标准下载网 >>
- 标准分类 >>
- 国家标准(GB) >>
- GB/T 6617-1995 硅片电阻率测定 扩展电阻探针法
标准号:
GB/T 6617-1995
标准名称:
硅片电阻率测定 扩展电阻探针法
标准类别:
国家标准(GB)
标准状态:
现行-
发布日期:
1995-04-18 -
实施日期:
1995-01-02 出版语种:
简体中文下载格式:
.rar.pdf下载大小:
157.72 KB
手机扫码下载更方便
标准ICS号:
29.040.30中标分类号:
冶金>>金属理化性能试验方法>>H21金属物理性能试验方法
替代情况:
GB 6617-1986采标情况:
=ASTM F525-88
点击下载
标准简介:
标准下载解压密码:www.bzxz.net
本标准规定了硅片电阻率的扩展电阻探针测量方法。本标准适用于测量晶体取向与导电类型已知的硅片的电阻率和测量与衬底同型或反型的硅外延层的电阻率。测量范围:10-3~102Ω·cm。 GB/T 6617-1995 硅片电阻率测定 扩展电阻探针法 GB/T6617-1995
部分标准内容:
中华人民共和国国家标准
硅片电阻率测定扩展电阻探针法Test method for measuring resistivity of siliconwafers using spreading resistance probe1主题内容与适用范围
本标准规定了硅片电阻率的扩展电阻探针测量方法。GB/T 6617-1995
代替661?86
本标准适用于测量晶体取向与导电类型已知的硅片的电阻率和測量与衬底同型或反型的硅外延层的电阻率。测量范围:10-3~~102Q·cm。2引用标准
GB1550硅单晶导电类型测定方法GB/T1552硅、锗单晶电阻率直排四探针测量方法GB1555硅单晶晶向光图测量方法GB1556硅单晶晶向X光衍射测量方法GB/T14847重掺杂衬底上轻掺杂硅外延层厚度的红外反射测量方法YS/T15硅外延层和扩散层厚度测定磨角染色法3方法提要www.bzxz.net
扩展电阻法是种实验比较法。该方法是先测量重复形成的点接触的扩展电阳,再用校准曲线来确定被测试样在探针接触点附近的电阻率。扩展电阻R。是导电金属探针与硅片上一个参考点之间的电势降与流过探针的电流之比。
4测量装置
4.1机械装置
4.1.1探针架:可采用单探针、两探针和三探针结构。探针架用作支承探针,使其以重复的速度和预定的压力将探针尖下降至试样表面,并可调节探针的接触点位置。4.1.2探针尖采用坚硬耐磨的良好导电材料如钱、碳化钨或钨-钉合金等制成。针尖曲率半径不大于25μm,夹角为30°~~60。针距为15~~1000μm。4.1.3样品台:绝缘真空吸盘或其他能将硅片固定的装置,能在互相垂直的两个方间上实现5~500m步距的位移。
4.1.4绝缘性,探针之间及任--探针与机座之间的直流绝缘电阻大于1(2。4.2电学测量装置
可采用恒压法、恒流法和对数比较器法,其电路图见图1、图2和图3。国家技术监督局1995-04-18批准1995.12-01实施
大面积背面电极
GB/T 6617-1995
电流测试仪
(a)单探针装置
恒压法电路
电压测试仪
大面积背面电极
(a)单探针装置
电压测试仪
(b)两探针装置
电压测试仪
(c)三探针装置
图2恒流法电路图
电流源
电流源
电压源
一试样
电流测试仪
(b)两探针装置
电压源
电压源
GB/T 6617--1995
对数比较器
大面积背面电极
(a)单探针装置
对数比较器
七斌样
(b)两探针装置
图3对数比较器电路
4.2.1直流电压源,恒压法用。具有1~20mV的可调恒定电压输出。当负载在1Q~10M0范围内变化时,电压输出变化在土0.1%以内。4.2.2直流电压源,比较器法用。恒定输出1~20mV。4.2.3可调直流电流源,恒流法用。电流范围10nA~10mA,精度在士0.1%以内。4.2.4直流电压测试仪,恒流法用。线性范围1~100mV,精度在士0.1%以内,输入阻抗不小于500MQ。
4.2.5直流电流测试仪,恒压法用。1nA~10mA,精确度在士0.1%以内。4.2.6对数比较器,比较器法用。输出电压与两个电流之比的对数成正比,当带有精密电阻R。时,能测量1α~10Mα电阻,偏离线性不超过士1%。4.2.7精密电阻,比较器法用。10kQ,精密度优于0.1%。4.3观测显微镜
放大倍数不小于400倍。
4.4温度计
温度范围0~40℃,分度值0.1℃。4.5消震台
用于支承探针架。
5测量程序
5.1测基环境
5.1.1测量环境温度为23±2℃,相对湿度不大于65%。5.1.2在漫射光或黑暗条件下进行测量。5.1.3必要时应进行电磁屏蔽。
5.1.4探针架置于消震台上。
5.1.5为保证小讯号测量条件,应使探针电势不大于20mV5.1.6应避免试样表面上存在OH-和F-离子。如果试样在制备或清洗中使用了含水溶剂或材料,测量前可将试样在140±20℃条件下于空气中热处理10~15min。5.2仪器推备
5.2.1如果使用多探针装督,调节探针间距到期望值,记录探针间距。333
GB/T 6617—1995
5.2.2选择探针负荷为0.1~1N,在多探针装置中,每一探针应使用相同负荷。5.2.3根据探针负荷,确定探针下降到试样上的速度。当负荷等于0.4N时,比较合适的探针下降速度为l mtm/s。
5.2.4将探针在用5um粒度研磨膏研磨过的硅片表面步进压触500次以上,或用8000~12000号的砂布或砂纸非常轻地修整探针尖,使针尖老化。5.2.5将针尖进行清洁处理。按5.4.3至5.4.7步骤测量1Q·cm均匀P型硅单晶样品扩展电阻。如果多次测量的扩展电阻值的相对标准偏差在士10%以内,并且平均值是在正常的扩展电阻值范围内,可认为针尖是良好的,否则该探针尖应重新老化或使用新探针尖。注:P型单晶样品背面应具有大面积欧姆接触。5.2.6如果使用两探针装置,使两个针分别以单探针结构在10·cm的P型带晶样品F测量扩展电阻,以证实两根针测得的扩展电阻是相等的(偏离在10%以内)。如果用相等的探针负荷和下降速度不能得到相等的阴值,则需再次老化或使用新探针尖。5.2.7在至少放大400倍的显微镜下检查探针压痕的重复性。如果给定探针得到的压痕不全部相似,应重新老化或使用新探针尖。:5.2.8连接合适的电路(见图1、图2和图3)。5.3校准
5.3.1在本方法电阻率测量范围内选择与被测试样相同晶向和导电类型的各种电阻率的校准样品,每-数量级至少3块。
5.3.2如果以前没有测量过校准样品的电阻率,按GB/T1552测量每块校准样品的电阻率,记录测量结果。
5.3.3采用与被测试样相同的材料与工艺,制备校准样品。如果是用四探针测量电阻率后第次制备样品,应至少除去25μm厚的样品表面。将校准样品清洗干净。5.3.4对每-校准样品,在四探针测量过的区域至少做20次扩展电阻测量,测量的长度大约等于四探针的两外探针之间的距离。
5.3.5计算每个校准样品测得的扩展电阻的平均值和标准偏差。当标准偏差小于平均值的10%时方可选作为校准样品。
5.3.6利用每个合格的校准样品的电阻率值和对应的扩展电阻平均值拟合得到Rs-校准曲线,绘制在双对数坐标纸上。
5.4测量
5.4.1按GB1550确定试样的导电类型,按GB1555或GB1556测定试样晶向;若试样为外延片·按GB/T14847或YS/T15测定试样的外延层厚度,记录测定结果。5.4.2选用合适的材料与工艺制备试样表面,清除表面损伤和沾污,以便获得稳定的电学测量表面。将试样清洗干净。外延片不需制备表面,5.4.3用真空吸盘或其他方法将试样固定在样品台上。调节试样或探针位置,使探针能降到试样上的预定测量位置。
5.4.4降下探针,使探针与试样接触。调节电压或电流到预定值的土0.1%以内(除了用比较器法)。记录所加的电压、电流或电阻R。值。5.4.5等待适当的稳定时间,测量和记录I,mA(恒压法);电势差V,mV(恒流法);或对数比较器输出,log(i/iz)(对数比较器法)。5.4.6提起探针。移动试样或探针至下一测基位置,最小步进距离应保证探针在试样表面产生的压痕不发生重叠,记录步距。
5.4.7重复5.4.4~~5.4.6步骤,直至完成预定的测量数。334
测量结果计算
6.1计算每次测量的扩展电阻R,Q。6.1.1恒压法
式中:V—外加电势差,mV;
测得的电流,mA。
6.1.2恒流法
式中:V---
测得的电势差,mV;
一外加的电流,mA。
6.1.3比较器法
式中:R。精密电阻阻值,;
log(it/iz)——对数比较器输出。6.2计算扩展电阻平均值R。,0。GB/T 6617.—1995
R。= Relog(i/iz)
6.3根据扩展电阻平均值,在Rs\p校准曲线上查得对应的电阻率值。6.4如果测量的是外延层,计算探针有效电接触半径a,cm。a=
-测定电势差时所包含的载流探针数。对单探针和三探针,n=1;对两探针,n一2;式中:n-\
试样的电阻率,n·cm;
R测得的扩展电阻,2。
如果外延层厚度大于20倍α时,得到的电阻率值可不必进行修正。7精密度
本方法多实验室测量精密度优于土80%(R3S)。8试验报告
试验报告应包括以下内容:
试样编号;
试样的导电类型、晶体取向,若是外延片,还应有外延层厚度及其测量方法;试样表面的制备条件;
环境温度;
探针间距、步距和探针负荷;
测量区域的平均电阻率值,如有必要,还应给出电阻率分布:本标准编号:
测量者;
测量日期。
附加说明:
6617-1995
本标准由中国有色金属工业总公司提出。本标准由上海有色金属研究所负责起草。本标准主要起草人施海青、张建宇、夏锦禄。本标准等效采用美国材料与试验协会标准ASTMF525-88《硅片电阻率测定扩展电阻探针
法》。
硅片电阻率测定扩展电阻探针法Test method for measuring resistivity of siliconwafers using spreading resistance probe1主题内容与适用范围
本标准规定了硅片电阻率的扩展电阻探针测量方法。GB/T 6617-1995
代替661?86
本标准适用于测量晶体取向与导电类型已知的硅片的电阻率和測量与衬底同型或反型的硅外延层的电阻率。测量范围:10-3~~102Q·cm。2引用标准
GB1550硅单晶导电类型测定方法GB/T1552硅、锗单晶电阻率直排四探针测量方法GB1555硅单晶晶向光图测量方法GB1556硅单晶晶向X光衍射测量方法GB/T14847重掺杂衬底上轻掺杂硅外延层厚度的红外反射测量方法YS/T15硅外延层和扩散层厚度测定磨角染色法3方法提要www.bzxz.net
扩展电阻法是种实验比较法。该方法是先测量重复形成的点接触的扩展电阳,再用校准曲线来确定被测试样在探针接触点附近的电阻率。扩展电阻R。是导电金属探针与硅片上一个参考点之间的电势降与流过探针的电流之比。
4测量装置
4.1机械装置
4.1.1探针架:可采用单探针、两探针和三探针结构。探针架用作支承探针,使其以重复的速度和预定的压力将探针尖下降至试样表面,并可调节探针的接触点位置。4.1.2探针尖采用坚硬耐磨的良好导电材料如钱、碳化钨或钨-钉合金等制成。针尖曲率半径不大于25μm,夹角为30°~~60。针距为15~~1000μm。4.1.3样品台:绝缘真空吸盘或其他能将硅片固定的装置,能在互相垂直的两个方间上实现5~500m步距的位移。
4.1.4绝缘性,探针之间及任--探针与机座之间的直流绝缘电阻大于1(2。4.2电学测量装置
可采用恒压法、恒流法和对数比较器法,其电路图见图1、图2和图3。国家技术监督局1995-04-18批准1995.12-01实施
大面积背面电极
GB/T 6617-1995
电流测试仪
(a)单探针装置
恒压法电路
电压测试仪
大面积背面电极
(a)单探针装置
电压测试仪
(b)两探针装置
电压测试仪
(c)三探针装置
图2恒流法电路图
电流源
电流源
电压源
一试样
电流测试仪
(b)两探针装置
电压源
电压源
GB/T 6617--1995
对数比较器
大面积背面电极
(a)单探针装置
对数比较器
七斌样
(b)两探针装置
图3对数比较器电路
4.2.1直流电压源,恒压法用。具有1~20mV的可调恒定电压输出。当负载在1Q~10M0范围内变化时,电压输出变化在土0.1%以内。4.2.2直流电压源,比较器法用。恒定输出1~20mV。4.2.3可调直流电流源,恒流法用。电流范围10nA~10mA,精度在士0.1%以内。4.2.4直流电压测试仪,恒流法用。线性范围1~100mV,精度在士0.1%以内,输入阻抗不小于500MQ。
4.2.5直流电流测试仪,恒压法用。1nA~10mA,精确度在士0.1%以内。4.2.6对数比较器,比较器法用。输出电压与两个电流之比的对数成正比,当带有精密电阻R。时,能测量1α~10Mα电阻,偏离线性不超过士1%。4.2.7精密电阻,比较器法用。10kQ,精密度优于0.1%。4.3观测显微镜
放大倍数不小于400倍。
4.4温度计
温度范围0~40℃,分度值0.1℃。4.5消震台
用于支承探针架。
5测量程序
5.1测基环境
5.1.1测量环境温度为23±2℃,相对湿度不大于65%。5.1.2在漫射光或黑暗条件下进行测量。5.1.3必要时应进行电磁屏蔽。
5.1.4探针架置于消震台上。
5.1.5为保证小讯号测量条件,应使探针电势不大于20mV5.1.6应避免试样表面上存在OH-和F-离子。如果试样在制备或清洗中使用了含水溶剂或材料,测量前可将试样在140±20℃条件下于空气中热处理10~15min。5.2仪器推备
5.2.1如果使用多探针装督,调节探针间距到期望值,记录探针间距。333
GB/T 6617—1995
5.2.2选择探针负荷为0.1~1N,在多探针装置中,每一探针应使用相同负荷。5.2.3根据探针负荷,确定探针下降到试样上的速度。当负荷等于0.4N时,比较合适的探针下降速度为l mtm/s。
5.2.4将探针在用5um粒度研磨膏研磨过的硅片表面步进压触500次以上,或用8000~12000号的砂布或砂纸非常轻地修整探针尖,使针尖老化。5.2.5将针尖进行清洁处理。按5.4.3至5.4.7步骤测量1Q·cm均匀P型硅单晶样品扩展电阻。如果多次测量的扩展电阻值的相对标准偏差在士10%以内,并且平均值是在正常的扩展电阻值范围内,可认为针尖是良好的,否则该探针尖应重新老化或使用新探针尖。注:P型单晶样品背面应具有大面积欧姆接触。5.2.6如果使用两探针装置,使两个针分别以单探针结构在10·cm的P型带晶样品F测量扩展电阻,以证实两根针测得的扩展电阻是相等的(偏离在10%以内)。如果用相等的探针负荷和下降速度不能得到相等的阴值,则需再次老化或使用新探针尖。5.2.7在至少放大400倍的显微镜下检查探针压痕的重复性。如果给定探针得到的压痕不全部相似,应重新老化或使用新探针尖。:5.2.8连接合适的电路(见图1、图2和图3)。5.3校准
5.3.1在本方法电阻率测量范围内选择与被测试样相同晶向和导电类型的各种电阻率的校准样品,每-数量级至少3块。
5.3.2如果以前没有测量过校准样品的电阻率,按GB/T1552测量每块校准样品的电阻率,记录测量结果。
5.3.3采用与被测试样相同的材料与工艺,制备校准样品。如果是用四探针测量电阻率后第次制备样品,应至少除去25μm厚的样品表面。将校准样品清洗干净。5.3.4对每-校准样品,在四探针测量过的区域至少做20次扩展电阻测量,测量的长度大约等于四探针的两外探针之间的距离。
5.3.5计算每个校准样品测得的扩展电阻的平均值和标准偏差。当标准偏差小于平均值的10%时方可选作为校准样品。
5.3.6利用每个合格的校准样品的电阻率值和对应的扩展电阻平均值拟合得到Rs-校准曲线,绘制在双对数坐标纸上。
5.4测量
5.4.1按GB1550确定试样的导电类型,按GB1555或GB1556测定试样晶向;若试样为外延片·按GB/T14847或YS/T15测定试样的外延层厚度,记录测定结果。5.4.2选用合适的材料与工艺制备试样表面,清除表面损伤和沾污,以便获得稳定的电学测量表面。将试样清洗干净。外延片不需制备表面,5.4.3用真空吸盘或其他方法将试样固定在样品台上。调节试样或探针位置,使探针能降到试样上的预定测量位置。
5.4.4降下探针,使探针与试样接触。调节电压或电流到预定值的土0.1%以内(除了用比较器法)。记录所加的电压、电流或电阻R。值。5.4.5等待适当的稳定时间,测量和记录I,mA(恒压法);电势差V,mV(恒流法);或对数比较器输出,log(i/iz)(对数比较器法)。5.4.6提起探针。移动试样或探针至下一测基位置,最小步进距离应保证探针在试样表面产生的压痕不发生重叠,记录步距。
5.4.7重复5.4.4~~5.4.6步骤,直至完成预定的测量数。334
测量结果计算
6.1计算每次测量的扩展电阻R,Q。6.1.1恒压法
式中:V—外加电势差,mV;
测得的电流,mA。
6.1.2恒流法
式中:V---
测得的电势差,mV;
一外加的电流,mA。
6.1.3比较器法
式中:R。精密电阻阻值,;
log(it/iz)——对数比较器输出。6.2计算扩展电阻平均值R。,0。GB/T 6617.—1995
R。= Relog(i/iz)
6.3根据扩展电阻平均值,在Rs\p校准曲线上查得对应的电阻率值。6.4如果测量的是外延层,计算探针有效电接触半径a,cm。a=
-测定电势差时所包含的载流探针数。对单探针和三探针,n=1;对两探针,n一2;式中:n-\
试样的电阻率,n·cm;
R测得的扩展电阻,2。
如果外延层厚度大于20倍α时,得到的电阻率值可不必进行修正。7精密度
本方法多实验室测量精密度优于土80%(R3S)。8试验报告
试验报告应包括以下内容:
试样编号;
试样的导电类型、晶体取向,若是外延片,还应有外延层厚度及其测量方法;试样表面的制备条件;
环境温度;
探针间距、步距和探针负荷;
测量区域的平均电阻率值,如有必要,还应给出电阻率分布:本标准编号:
测量者;
测量日期。
附加说明:
6617-1995
本标准由中国有色金属工业总公司提出。本标准由上海有色金属研究所负责起草。本标准主要起草人施海青、张建宇、夏锦禄。本标准等效采用美国材料与试验协会标准ASTMF525-88《硅片电阻率测定扩展电阻探针
法》。
小提示:此标准内容仅展示完整标准里的部分截取内容,若需要完整标准请到上方自行免费下载完整标准文档。
标准图片预览:

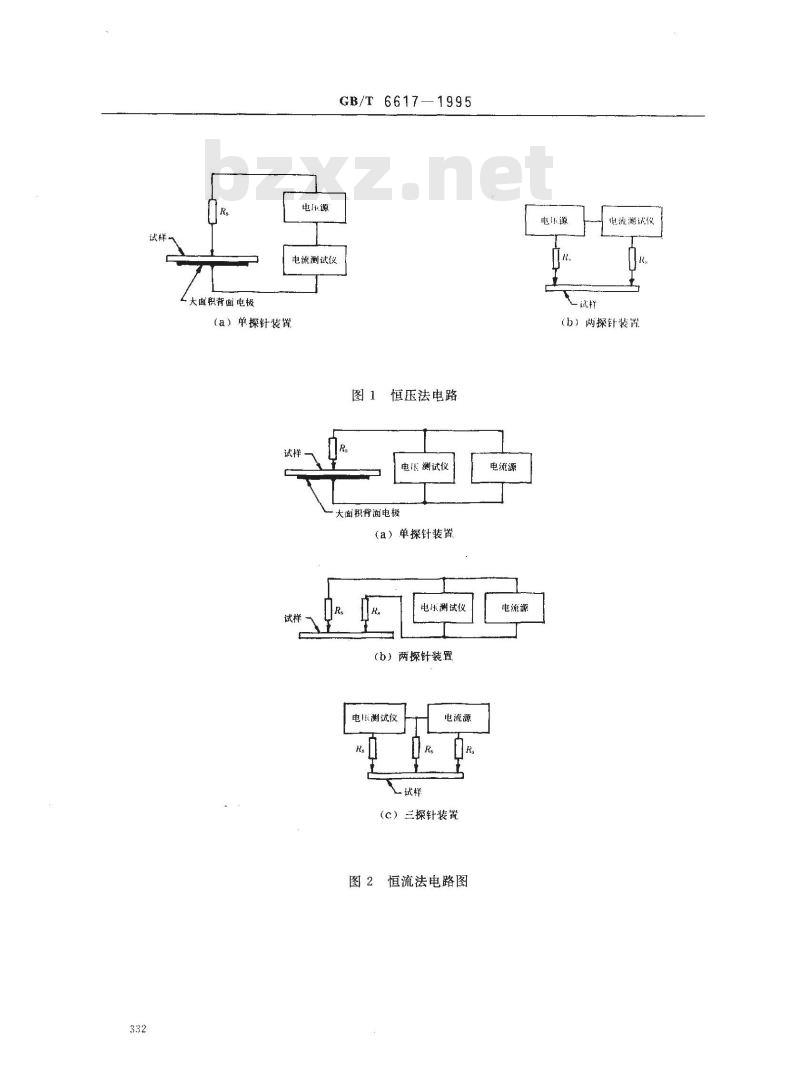



- 热门标准
- 国家标准(GB)
- GB/T38627-2020 信息技术 实时定位 磁定位数据接口
- GB/T8878—2014 棉针织内衣
- GB/T1182-2018 产品几何技术规范(GPS) 几何公差 形状、方向、位置和跳动公差标注
- GB175-2023 通用硅酸盐水泥
- GB/T12949-1991 滑动轴承覆有减摩塑料层的双金属轴套
- GB/T15349-1994 化学试剂 溴甲酚绿
- GB/T97.1-2002 平垫圈A级
- GB/T10125-2021 人造气氛腐蚀试验 盐雾试验
- GB/T228.1-2021 金属材料 拉伸试验 第1部分:室温试验方法
- GB/T43802-2024 绿色产品评价 物流周转箱
- GB/T42970-2023 半导体集成电路 视频编解码电路测试方法
- GB31094-2014 防爆电梯制造与安装安全规范
- GB50300-2013 建筑工程施工质量验收统一标准
- GB/T38987-2020 硬质合金螺旋孔棒材
- GB9178-1988 集成电路术语
- 行业新闻
请牢记:“bzxz.net”即是“标准下载”四个汉字汉语拼音首字母与国际顶级域名“.net”的组合。 ©2025 标准下载网 www.bzxz.net 本站邮件:wymp4wang@gmail.com