- 您的位置:
- 标准下载网 >>
- 标准分类 >>
- 国家标准(GB) >>
- GB/T 6621-1995 硅抛光片表面平整度测试方法
标准号:
GB/T 6621-1995
标准名称:
硅抛光片表面平整度测试方法
标准类别:
国家标准(GB)
标准状态:
现行-
发布日期:
1995-04-18 -
实施日期:
1995-01-02 出版语种:
简体中文下载格式:
.rar.pdf下载大小:
213.93 KB
手机扫码下载更方便
标准ICS号:
29.040.30中标分类号:
冶金>>金属理化性能试验方法>>H21金属物理性能试验方法
替代情况:
GB 6621-1986采标情况:
ASTM F 775-1988,EQV
点击下载
标准简介:
标准下载解压密码:www.bzxz.net
本标准规定了用相干光的干涉现象测量硅抛光片表面平整度的方法。本标准适用于检测硅抛光片的表面平整度,也适用于检测硅外延片和类镜面状半导体晶片的表面平整度。 GB/T 6621-1995 硅抛光片表面平整度测试方法 GB/T6621-1995
部分标准内容:
中华人民共和国国家标准
硅抛光片表面平整度测试方法
Test methods for surface flatness of silicon polished slices第一篇方法A
主题内容与适用范围
光于涉法
本标准规定了用相于光的干涉现象测量硅抛光片表面平整度的方法,GB/T 6621—1995
代替GB6621--86
本标准适用于检测硅抛光片的表面平整度,也适用于检测硅外延片和类镜面状半导体晶片的表面平整度。
2术语
2.1总指示读数(TIR)total indicator runout(TIR)两个与基准平面平行的平面之间的最小垂直距离。处于晶片正面的固定优质区(FQA)或局部优质区域内的所有的点在两平行平面的范围内。又称最大峰一惊射入射干涉仪参考楼镜
基准面
峰偏差
蜂对容偏差
谷偏差
谷差(见图1)。
等测试样的1:表面
图1基片计量学定义
注:峰和谷的位置可能出现在试样表面的任何地方。2.2 焦平面 focal plane
国家技术监督局1995-04-18批准354
1995.12-01实施
GB/T6621--1995
与成像系统的光轴垂直且包含成像系统焦点的平面。2.3焦平面偏差(FPD)focal planedeviation(FPD)从晶片表面的一点平行于光轴到焦平面的距离。2.4最大焦平面偏差maximumfocalplanedeviation焦平面偏差(FPD)的最大绝对值,简称最大峰(谷)与焦平面的偏差。3方法提要
用真空吸盘吸持试样的背面,使试样表面尽可能靠近干涉仪的基准面,来自单色光源的平面波受到试样表面和十涉仪的基准平面的反射,在空间迭加形成光干涉。由于各处光程差不同,在屏幕上出现干涉条纹(见图2、图3)。分析得到的干涉条纹,可度量试样表面平整度,并用总指示读数(TIR)表示。显示屏
试样固定架
观察透镜
基准棱镜
准直透镜
基准面
毛坡璃盘:
聚焦透镜一
·单色光源
图2掠射入射干涉仪示意图
4测量装置
至干涉仪条纹,
观察装置
GB/T6621—1995
基准校镜
参考光束
测试光束
待测表面
图3测试光束和参考光束
基准面
4.1掠射入射干涉仪:由单色光源、聚焦透镜、毛玻璃散射盘、准直透镜,带有基准面的基准棱镜、目镜和观察屏组成。仪器灵敏度不低于0.1um,并可调节其灵敏度大小(见图2)。4.2真空泵和真空量规:真空度不低于66.661kPa。4.3真空吸盘:其表面平整度应小于0.25μm,吸盘的直径与待测试样的直径相匹配。4.4校准劈:为平整度已知的光学平晶,用于校推干涉仪的灵敏度(见图4)。3.56
5试样
50mm×75mm
开高的光学平面
70mmx110mm×16mm
石英或类似材料
100μm
GB/T6621—1995
校准酵
注:比例1:2
干涉仪基准面平面
端头抛光的碳化物销钉
可调换的销钉周定器
粘合在玻璃中的村套
销钉安装详图
往:比例5: 1
图4校准劈
按照规定的抽样方案或商定的抽样方案抽取试样。6测量程序
6.1校准
确定掠射入射干涉仪的灵敏度。6.1.1将校准劈的锁钉和干涉仪的基准面相接触,使校准劈的平面与干涉仪的基准面之间形成空气劈,沿着劈的方向,其儿何厚度呈线性变化。在入射角一定的情况下,使两束相干平面波之间的光程差357
GB/T66211995
沿劈的方向产生周期性的变化,导致在观察屏上呈现一组平行的干涉条纹,方向与劈的方向相垂直(见图4)。
6.1.2调整干涉仪入射光束在校准劈反射面上入射角8,使已知校准劈平整度等于其光程差与干涉条纹之比值,此时校准劈平整度就确定为掠射入射干涉仪的灵敏度d。6.2真空吸盘平整度的检查
6.2.1将干涉仪的灵敏度调到0.5um/条,使吸盘表面尽可能靠近十涉仪的基准面。6.2.2调节真空吸盘相对干涉仪的倾斜度,使屏幕上出现4~6条干涉条纹为止。6.2.3按照出现条纹数估算吸盘平整度,如TIR大于0.25m,则弃去另换一个,重新按6.2条估算,直到吸盘乎整度TIR不大于0.25um为出。6.3测量
6.3.1测量环境的洁净等级不低于100级。6.3.2联接真空泵和吸盘,并用真空量规检查真空度,使其不低于66.661kPa。6.3.3将试样的背面吸持在适宜的真空吸盘上。6.3.4
使试样的表面尽可能靠近干涉仪的基准面,但不可接触基准面。调节真空吸盘的倾斜控制器,消除因试样倾斜而产生的干涉条纹,直到看见的条纹数目最少(见6.3.5
图5)。
6.3.6确定试样表面优质区内的最高点和最低点,即峰和谷,读出峰谷之间产生对应的完整和不完整条纹的总数目。
6.3.7如果条纹数超过10条,则需要将干涉仪的灵敏度调低一倍(减小入射角),重复6.3.4~6.3.6条操作。
6.3.8如果条纹数少于2条,则需要将干涉仪的灵敏度调高一倍(增加入射角),重复6.3.4~6.3.6条操作。
有倾斜
球形表面
疯桂枝面
马鞍形表面
无顏解
图5有无倾斜时的三种典型干涉图358
GB/T 6621—1995
注:①在每种情况下,峰对谷平整度等于两条条纹。②当无倾斜时,最小的干涉条纹数代表表面形状。③数字0代表高的区域,数字2代表低的区域。7 测量结果计算
7.1掠射入射干涉仪的灵敏度由式(1)计算:d - ^/2n cos0
式中:d一掠射人射干涉仪的灵敏度,um/条;-一入射光和待测试样表面法线之间的夹角,rad;^—干涉仪光源的波长,μm;
n一一与待测表面相邻介质的折射率(对空气n一1)7.2将校准过的干涉仪的灵敏度d乘以试样的表面最高点和最低点之间(峰与谷)对应的完整和不完整干涉条纹的总数目M,即得到最大峰—一谷间的偏差(TIR)。由下式表示:TIR - M- d
式中:TIR一
总指示读数,μm;
d-—干涉仪的灵敏度,μm/条;M干涉条纹的总数目,条。
8精密度
本方法单实验室精密度TIR为士30.6%(R3S)。9试验报告
报告应包括以下内容:
试样编号;
试样表面的优质区域(FQA);
干涉仪型号;
干涉仪在测试时的灵敏度d;
真空度,kPa;
实验室洁净等级;
试样表面峰谷间的完整和不完整干涉条纹总数目;平整度值(TIR);
本标编号;bzxz.net
测量单位和测量者;
测量日期。
第二篇 方法B—一电容法
10主题内容与适用范围
本标准规定了用电容位移传感测定硅抛光片表面平整度的方法。·(2)
GB/T 6621—1995
本标准适用于测量批量硅抛光片的表面平整度和直观地描绘硅片表面的轮廓形貌。11方法提要
11.1将硅片平放入一对同轴对置的电容位移传感器(简称探头)之间,对探头施加一高频电压,硅片与探头之间便产生了高频电场,其间各形成了·个电容。探头中电路测量其间电流变化量,便可测得该电容值C。如图6所示。C由公式(3)给出:上探头
下探头
图6电容位移传感器测量方法示意图T一硅片的厚度;D两探头间的距离;di-上探头到硅片上表面的位移,d2--下探头到硅片下表面的位移C
式中:C—-在上、下探头和硅片表面之间所测得总电容值,F;K~一自由空间介电常数,F/m;
A-一探头表面积,m;
d.上探头到硅片上表面的位移,m;d2-\下探头到硅片下表面的位移,m;C———主要由探头结构的特征而产生的寄生电容,F。(3)
11.2由于在测量时,两探头之间距离和下探头到硅片下表面的距离dz已在校准时被固定,所以仪器测得电容值C按公式(3)进行计算,就得到d1,从而计算硅片表面平整度和其他几何尺寸。11.3按计算得到的硅片表面几何尺寸,以等高线图或正投影的形式,描绘硅片表面的轮廓形貌,借助图形计算机,打印显示并作出硅片表面轮廓图360
12仪器装置
GB/T6621—1995
12.1带显示的平整度台:包括两个探头、真空吸盘,探头支承架、运算和图形计算机。12.1.1在扫描中,对自动数据采样模式的仪器,采集数据的能力每秒钟至少100个数据点。12.1.2探头:其灵敏度应小于0.25μm。12.1.3真空吸盘:其表面平整度应小于0.2um,其直径不大于$23.4mm,真空度不低于66.661kPa。12.2厚度校准样片:测量仪器应备有的附件,用以校准仪器。13试样
按照规定的抽样方案或商定的抽样方案抽取试样。14,测量程序
14.1校准
14.1.1经清洗过的吸盘和上、下探头安装在合适的位置上,并轴向对准,待校准仪器。14.1.2输入最接近待测批量硅片的标称厚度值的标准厚度样片的数值。令该样片为1\样片,与1#样片的厚度值相差为土50μm的标准样片分别为2#、3\样片。14.1.3输入2*或3#样片的厚度值。14.1.4将1\样片放在两探头之间,由真空吸盘吸持并对中,然后调节上探头调节轮,使显示屏上读数为零。
14.1.5以吸盘上移去1\样片,放上2\或3\样片,吸盘吸持并对中,然后调节上探头调节轮,使显示屏上读数为零。
14.1.6移去2\或3样片。此时仪器已校准完毕。14.2测量
14.2.1测量环境的洁净等级不低于100级。14.2.2选择“校准”模式,按14.1条进行。14.2.3选择手动”模式,使一些已知值的硅片在平整度台上运行,如得到准确测结果,批量硅片就可运行。否则重复14.2.2条进行。14.2.4运行的硅片经平整台扫描后,测量出探头到硅片表面各点的电容值C,按公式(3)计算出探头到硅片表面上各点的位移。
14.2.4.1确定一个焦平面:由硅片正表面上以最小2乘法拟合的平面或由硅片离边缘等间距处的3个点组成的一个平面。
14.2.5计算出硅片表面上点到焦平面的最大位移,其作为最大FPD的度量,经显示屏显示。14.2.6计算出FPD的最大值和最小值之差,其作为TIR的度量,经显示屏上显示。14.2.7选择“自动”模式,硅片将从片盒平移送到平整度台进行测试,经运算计算机运算后,自动显示出批量硅片 FPD、TIR,并打印出来。14.3形貌图形显示
14.3.1将特殊需要形貌轮廓图形显示的硅片的表面几何尺寸参数,图形类别,作图形式等输入图形计算机,或摄取储存在运算计算机中的硅片表面几何尺寸参数。14.3.2经图形计算机运行,硅片表面轮廓形貌就按下列四种图形显示并作图。14.3.2.1三维等高轮廓图;
14.3.2.2二维形貌图,
14.3.2.3三维正投影图;
14.3.2.4剖面图。
15计算
GB/T6621--1995
15.1按公式(3)计算出探头到硅片表面各点的位移值。15.2确定个焦平面。
15.3FPD为硅片表面各点到焦平面的位移,最大FPD为FPD的最大绝对值15.4TIR为FPD的最大值和FPD的最小值之差。15.5仪器经运算计算机运行,白动显示并打印批量硅片最大FPD、TIR精密度
16.1本方法单实验室精密度,FPD为0%(R3S)。TIR为0%
2本方法多实验室精密度:FPD为士25%R3S16.2
TIR 为±24%
试验报告
报告应包括以下内容
试样编号;
试样表面的优质区域(FQA);
仪器型号;
仪器在测试时的灵敏度;
真空度 kPa;
实验室的洁净等级;
测试结果:最大FPD和TIR;
本标准编号;
测量单位和测量者;
测量日期。
如有特殊要求,报告也应包括下列内容:三维轮廓图;
二维形貌图:
正投影图;
剖面图。
附加说明:
本标准由中国有色金属工业总公司提出。本标准由上海第二冶炼厂负责起草。本标准主要起草人杨灏、严世权、陆梓康本标准方法A等效采用美国材料与试验协会标准ASTMF775-88《用无接触干涉技术测量晶片平整度的标准方法》
硅抛光片表面平整度测试方法
Test methods for surface flatness of silicon polished slices第一篇方法A
主题内容与适用范围
光于涉法
本标准规定了用相于光的干涉现象测量硅抛光片表面平整度的方法,GB/T 6621—1995
代替GB6621--86
本标准适用于检测硅抛光片的表面平整度,也适用于检测硅外延片和类镜面状半导体晶片的表面平整度。
2术语
2.1总指示读数(TIR)total indicator runout(TIR)两个与基准平面平行的平面之间的最小垂直距离。处于晶片正面的固定优质区(FQA)或局部优质区域内的所有的点在两平行平面的范围内。又称最大峰一惊射入射干涉仪参考楼镜
基准面
峰偏差
蜂对容偏差
谷偏差
谷差(见图1)。
等测试样的1:表面
图1基片计量学定义
注:峰和谷的位置可能出现在试样表面的任何地方。2.2 焦平面 focal plane
国家技术监督局1995-04-18批准354
1995.12-01实施
GB/T6621--1995
与成像系统的光轴垂直且包含成像系统焦点的平面。2.3焦平面偏差(FPD)focal planedeviation(FPD)从晶片表面的一点平行于光轴到焦平面的距离。2.4最大焦平面偏差maximumfocalplanedeviation焦平面偏差(FPD)的最大绝对值,简称最大峰(谷)与焦平面的偏差。3方法提要
用真空吸盘吸持试样的背面,使试样表面尽可能靠近干涉仪的基准面,来自单色光源的平面波受到试样表面和十涉仪的基准平面的反射,在空间迭加形成光干涉。由于各处光程差不同,在屏幕上出现干涉条纹(见图2、图3)。分析得到的干涉条纹,可度量试样表面平整度,并用总指示读数(TIR)表示。显示屏
试样固定架
观察透镜
基准棱镜
准直透镜
基准面
毛坡璃盘:
聚焦透镜一
·单色光源
图2掠射入射干涉仪示意图
4测量装置
至干涉仪条纹,
观察装置
GB/T6621—1995
基准校镜
参考光束
测试光束
待测表面
图3测试光束和参考光束
基准面
4.1掠射入射干涉仪:由单色光源、聚焦透镜、毛玻璃散射盘、准直透镜,带有基准面的基准棱镜、目镜和观察屏组成。仪器灵敏度不低于0.1um,并可调节其灵敏度大小(见图2)。4.2真空泵和真空量规:真空度不低于66.661kPa。4.3真空吸盘:其表面平整度应小于0.25μm,吸盘的直径与待测试样的直径相匹配。4.4校准劈:为平整度已知的光学平晶,用于校推干涉仪的灵敏度(见图4)。3.56
5试样
50mm×75mm
开高的光学平面
70mmx110mm×16mm
石英或类似材料
100μm
GB/T6621—1995
校准酵
注:比例1:2
干涉仪基准面平面
端头抛光的碳化物销钉
可调换的销钉周定器
粘合在玻璃中的村套
销钉安装详图
往:比例5: 1
图4校准劈
按照规定的抽样方案或商定的抽样方案抽取试样。6测量程序
6.1校准
确定掠射入射干涉仪的灵敏度。6.1.1将校准劈的锁钉和干涉仪的基准面相接触,使校准劈的平面与干涉仪的基准面之间形成空气劈,沿着劈的方向,其儿何厚度呈线性变化。在入射角一定的情况下,使两束相干平面波之间的光程差357
GB/T66211995
沿劈的方向产生周期性的变化,导致在观察屏上呈现一组平行的干涉条纹,方向与劈的方向相垂直(见图4)。
6.1.2调整干涉仪入射光束在校准劈反射面上入射角8,使已知校准劈平整度等于其光程差与干涉条纹之比值,此时校准劈平整度就确定为掠射入射干涉仪的灵敏度d。6.2真空吸盘平整度的检查
6.2.1将干涉仪的灵敏度调到0.5um/条,使吸盘表面尽可能靠近十涉仪的基准面。6.2.2调节真空吸盘相对干涉仪的倾斜度,使屏幕上出现4~6条干涉条纹为止。6.2.3按照出现条纹数估算吸盘平整度,如TIR大于0.25m,则弃去另换一个,重新按6.2条估算,直到吸盘乎整度TIR不大于0.25um为出。6.3测量
6.3.1测量环境的洁净等级不低于100级。6.3.2联接真空泵和吸盘,并用真空量规检查真空度,使其不低于66.661kPa。6.3.3将试样的背面吸持在适宜的真空吸盘上。6.3.4
使试样的表面尽可能靠近干涉仪的基准面,但不可接触基准面。调节真空吸盘的倾斜控制器,消除因试样倾斜而产生的干涉条纹,直到看见的条纹数目最少(见6.3.5
图5)。
6.3.6确定试样表面优质区内的最高点和最低点,即峰和谷,读出峰谷之间产生对应的完整和不完整条纹的总数目。
6.3.7如果条纹数超过10条,则需要将干涉仪的灵敏度调低一倍(减小入射角),重复6.3.4~6.3.6条操作。
6.3.8如果条纹数少于2条,则需要将干涉仪的灵敏度调高一倍(增加入射角),重复6.3.4~6.3.6条操作。
有倾斜
球形表面
疯桂枝面
马鞍形表面
无顏解
图5有无倾斜时的三种典型干涉图358
GB/T 6621—1995
注:①在每种情况下,峰对谷平整度等于两条条纹。②当无倾斜时,最小的干涉条纹数代表表面形状。③数字0代表高的区域,数字2代表低的区域。7 测量结果计算
7.1掠射入射干涉仪的灵敏度由式(1)计算:d - ^/2n cos0
式中:d一掠射人射干涉仪的灵敏度,um/条;-一入射光和待测试样表面法线之间的夹角,rad;^—干涉仪光源的波长,μm;
n一一与待测表面相邻介质的折射率(对空气n一1)7.2将校准过的干涉仪的灵敏度d乘以试样的表面最高点和最低点之间(峰与谷)对应的完整和不完整干涉条纹的总数目M,即得到最大峰—一谷间的偏差(TIR)。由下式表示:TIR - M- d
式中:TIR一
总指示读数,μm;
d-—干涉仪的灵敏度,μm/条;M干涉条纹的总数目,条。
8精密度
本方法单实验室精密度TIR为士30.6%(R3S)。9试验报告
报告应包括以下内容:
试样编号;
试样表面的优质区域(FQA);
干涉仪型号;
干涉仪在测试时的灵敏度d;
真空度,kPa;
实验室洁净等级;
试样表面峰谷间的完整和不完整干涉条纹总数目;平整度值(TIR);
本标编号;bzxz.net
测量单位和测量者;
测量日期。
第二篇 方法B—一电容法
10主题内容与适用范围
本标准规定了用电容位移传感测定硅抛光片表面平整度的方法。·(2)
GB/T 6621—1995
本标准适用于测量批量硅抛光片的表面平整度和直观地描绘硅片表面的轮廓形貌。11方法提要
11.1将硅片平放入一对同轴对置的电容位移传感器(简称探头)之间,对探头施加一高频电压,硅片与探头之间便产生了高频电场,其间各形成了·个电容。探头中电路测量其间电流变化量,便可测得该电容值C。如图6所示。C由公式(3)给出:上探头
下探头
图6电容位移传感器测量方法示意图T一硅片的厚度;D两探头间的距离;di-上探头到硅片上表面的位移,d2--下探头到硅片下表面的位移C
式中:C—-在上、下探头和硅片表面之间所测得总电容值,F;K~一自由空间介电常数,F/m;
A-一探头表面积,m;
d.上探头到硅片上表面的位移,m;d2-\下探头到硅片下表面的位移,m;C———主要由探头结构的特征而产生的寄生电容,F。(3)
11.2由于在测量时,两探头之间距离和下探头到硅片下表面的距离dz已在校准时被固定,所以仪器测得电容值C按公式(3)进行计算,就得到d1,从而计算硅片表面平整度和其他几何尺寸。11.3按计算得到的硅片表面几何尺寸,以等高线图或正投影的形式,描绘硅片表面的轮廓形貌,借助图形计算机,打印显示并作出硅片表面轮廓图360
12仪器装置
GB/T6621—1995
12.1带显示的平整度台:包括两个探头、真空吸盘,探头支承架、运算和图形计算机。12.1.1在扫描中,对自动数据采样模式的仪器,采集数据的能力每秒钟至少100个数据点。12.1.2探头:其灵敏度应小于0.25μm。12.1.3真空吸盘:其表面平整度应小于0.2um,其直径不大于$23.4mm,真空度不低于66.661kPa。12.2厚度校准样片:测量仪器应备有的附件,用以校准仪器。13试样
按照规定的抽样方案或商定的抽样方案抽取试样。14,测量程序
14.1校准
14.1.1经清洗过的吸盘和上、下探头安装在合适的位置上,并轴向对准,待校准仪器。14.1.2输入最接近待测批量硅片的标称厚度值的标准厚度样片的数值。令该样片为1\样片,与1#样片的厚度值相差为土50μm的标准样片分别为2#、3\样片。14.1.3输入2*或3#样片的厚度值。14.1.4将1\样片放在两探头之间,由真空吸盘吸持并对中,然后调节上探头调节轮,使显示屏上读数为零。
14.1.5以吸盘上移去1\样片,放上2\或3\样片,吸盘吸持并对中,然后调节上探头调节轮,使显示屏上读数为零。
14.1.6移去2\或3样片。此时仪器已校准完毕。14.2测量
14.2.1测量环境的洁净等级不低于100级。14.2.2选择“校准”模式,按14.1条进行。14.2.3选择手动”模式,使一些已知值的硅片在平整度台上运行,如得到准确测结果,批量硅片就可运行。否则重复14.2.2条进行。14.2.4运行的硅片经平整台扫描后,测量出探头到硅片表面各点的电容值C,按公式(3)计算出探头到硅片表面上各点的位移。
14.2.4.1确定一个焦平面:由硅片正表面上以最小2乘法拟合的平面或由硅片离边缘等间距处的3个点组成的一个平面。
14.2.5计算出硅片表面上点到焦平面的最大位移,其作为最大FPD的度量,经显示屏显示。14.2.6计算出FPD的最大值和最小值之差,其作为TIR的度量,经显示屏上显示。14.2.7选择“自动”模式,硅片将从片盒平移送到平整度台进行测试,经运算计算机运算后,自动显示出批量硅片 FPD、TIR,并打印出来。14.3形貌图形显示
14.3.1将特殊需要形貌轮廓图形显示的硅片的表面几何尺寸参数,图形类别,作图形式等输入图形计算机,或摄取储存在运算计算机中的硅片表面几何尺寸参数。14.3.2经图形计算机运行,硅片表面轮廓形貌就按下列四种图形显示并作图。14.3.2.1三维等高轮廓图;
14.3.2.2二维形貌图,
14.3.2.3三维正投影图;
14.3.2.4剖面图。
15计算
GB/T6621--1995
15.1按公式(3)计算出探头到硅片表面各点的位移值。15.2确定个焦平面。
15.3FPD为硅片表面各点到焦平面的位移,最大FPD为FPD的最大绝对值15.4TIR为FPD的最大值和FPD的最小值之差。15.5仪器经运算计算机运行,白动显示并打印批量硅片最大FPD、TIR精密度
16.1本方法单实验室精密度,FPD为0%(R3S)。TIR为0%
2本方法多实验室精密度:FPD为士25%R3S16.2
TIR 为±24%
试验报告
报告应包括以下内容
试样编号;
试样表面的优质区域(FQA);
仪器型号;
仪器在测试时的灵敏度;
真空度 kPa;
实验室的洁净等级;
测试结果:最大FPD和TIR;
本标准编号;
测量单位和测量者;
测量日期。
如有特殊要求,报告也应包括下列内容:三维轮廓图;
二维形貌图:
正投影图;
剖面图。
附加说明:
本标准由中国有色金属工业总公司提出。本标准由上海第二冶炼厂负责起草。本标准主要起草人杨灏、严世权、陆梓康本标准方法A等效采用美国材料与试验协会标准ASTMF775-88《用无接触干涉技术测量晶片平整度的标准方法》
小提示:此标准内容仅展示完整标准里的部分截取内容,若需要完整标准请到上方自行免费下载完整标准文档。
标准图片预览:



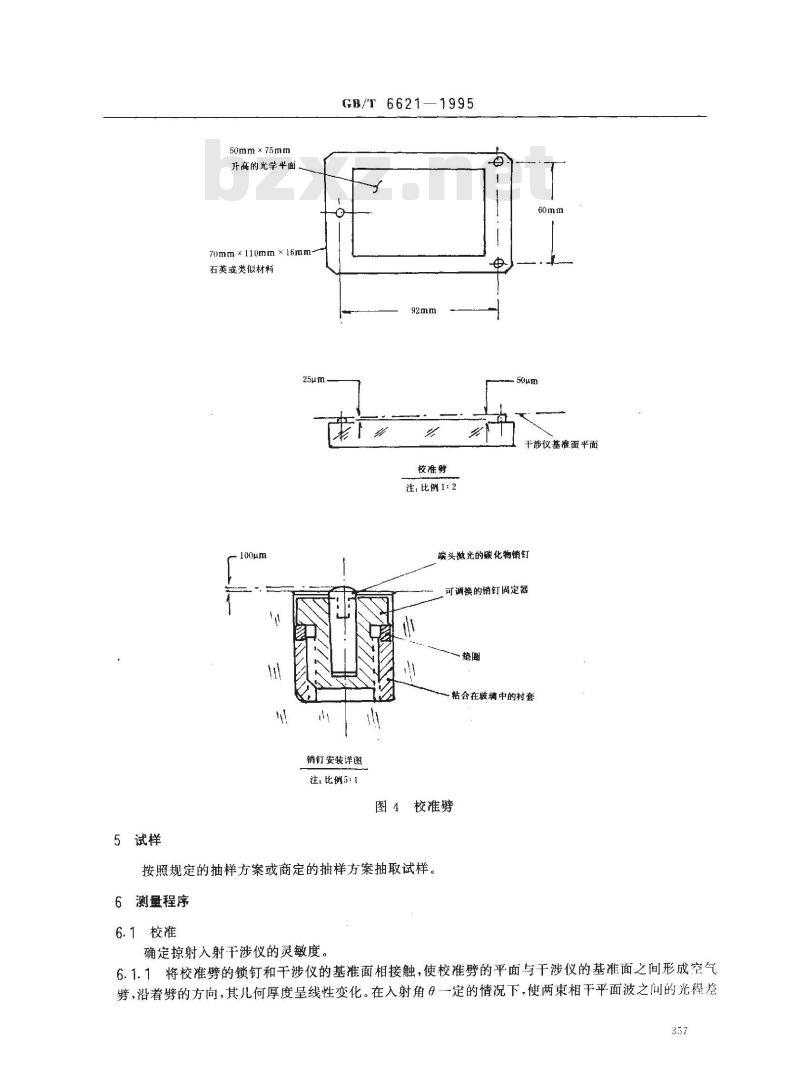

- 其它标准
- 热门标准
- 国家标准(GB)
- GB/T38627-2020 信息技术 实时定位 磁定位数据接口
- GB/T8878—2014 棉针织内衣
- GB/T1182-2018 产品几何技术规范(GPS) 几何公差 形状、方向、位置和跳动公差标注
- GB175-2023 通用硅酸盐水泥
- GB/T12949-1991 滑动轴承覆有减摩塑料层的双金属轴套
- GB/T15349-1994 化学试剂 溴甲酚绿
- GB/T97.1-2002 平垫圈A级
- GB/T10125-2021 人造气氛腐蚀试验 盐雾试验
- GB/T228.1-2021 金属材料 拉伸试验 第1部分:室温试验方法
- GB/T43802-2024 绿色产品评价 物流周转箱
- GB/T42970-2023 半导体集成电路 视频编解码电路测试方法
- GB31094-2014 防爆电梯制造与安装安全规范
- GB50300-2013 建筑工程施工质量验收统一标准
- GB/T38987-2020 硬质合金螺旋孔棒材
- GB9178-1988 集成电路术语
- 行业新闻
请牢记:“bzxz.net”即是“标准下载”四个汉字汉语拼音首字母与国际顶级域名“.net”的组合。 ©2025 标准下载网 www.bzxz.net 本站邮件:wymp4wang@gmail.com